摘要: 随着移动电子产品趋向轻巧、多功能、低功耗发展,为了在更小的封装面积下容纳更多的引脚数,因而发展出晶圆级芯片封装WLCSP。
随着移动电子产品趋向轻巧、多功能、低功耗发展,为了在更小的封装面积下容纳更多的引脚数,因而发展出晶圆级芯片封装WLCSP。它具备更多的功能集成、在体积、成本和性能方面更具优势,可以应用在移动电话、蓝牙产品、医疗设备、射频收发器、电源管理单元、音频放大器和GPS模块使用。
什么是晶圆级芯片封装WLCSP呢?
大家可能比较熟悉BGA,CSP就是小型的BGA,外形和球间距比 BGA小,球间距小于0.8毫米的BGA称为CSP,或者封装面积和里面芯片的面积之比小于1.2。
至于WLCSP,就是晶圆级CSP,即是大型的倒装晶片,中间没有载体,焊球直接植于硅基材上,一般焊球间距为0.4至0.8毫米间。由于晶圆级芯片封装的密间距,其敏感度远远超过BGA。
那么,在组装晶圆级芯片封装这种具有焊球直径小、焊球间距小、外形尺寸小的元器件特征时,厂家要注意什么呢?环球仪器提出了什么解决方案呢?
晶圆级芯片封装的装配流程
目前有两种工艺,一种是锡膏装配,但为了避免“桥连”或“少锡”缺陷,环球仪器建议采用助焊剂浸蘸的方法进行组装。
工艺流程:
拾取晶圆级芯片封装
浸蘸助焊剂
贴装晶圆级芯片封装
回流焊接
底部填充(如有需要)
在这里先集中讨论浸蘸助焊剂流程,环球仪器建议采用助焊剂薄膜浸蘸方式,即在元器件贴装前浸蘸一定厚度的助焊剂薄膜,使每个焊球上附着一定量的助焊剂。
采用助焊剂薄膜浸蘸的两大优点:
易于安装及操作
无论是锡铅或无铅焊点都能获得较好的润湿效果,当然也和回流焊接工艺相关
采用助焊剂薄膜浸蘸的两大挑战:
焊球高度的差异、焊球的氧化程度及温湿度变化影响焊球获得助焊剂的量
黏性助焊剂持续暴露在空气中
助焊剂应用单元是控制助焊剂浸蘸工艺的重要部分,其工作的基本原理,就是要获得设定厚度且稳定的助焊剂薄膜,使各焊球蘸取的助焊剂量一致。
要精确稳定的控制助焊剂薄膜的厚度,同时满足高速浸蘸的要求,必须满足以下要求:
1.可以多枚(如4或7枚)元件同时浸蘸助焊剂来提高产量
2.助焊剂应用单元应该简单、易操作、易控制、易清洁
3.可以处理很广泛的助焊剂或锡膏,适合浸蘸工艺的助焊剂黏度范围较宽、对于较稀和较黏的助焊剂都要能处理,而且获得的薄膜厚度要圴匀
4.蘸取工艺可以精确控制,浸蘸的工艺参数因材料的不同而会有差异,所以浸蘸过程工艺参数必须可以单独控制,如往下的速度、压力、停留时间和向上的加速度等。
环球仪器的线性薄膜敷料器可以产生一层薄薄的助焊剂、焊膏和粘合剂,应对单独或群组浸蘸晶圆CSP,将需要的材料量涂敷到合适的区域上。
它主要由两个部分组成,固定不动盛载助焊剂的糟,避免助焊剂持续暴露在空气中;和可以来回直线运动、具有不同深度的助焊剂盘。
助焊剂槽内的助焊剂不断补充到底下来回运动的助焊剂盘内,稳定后,助焊剂厚度相当于该盘的深度。只要使用不同深度的盘子,就可以获得不同厚度的助焊剂,适应于不同高度的焊球。
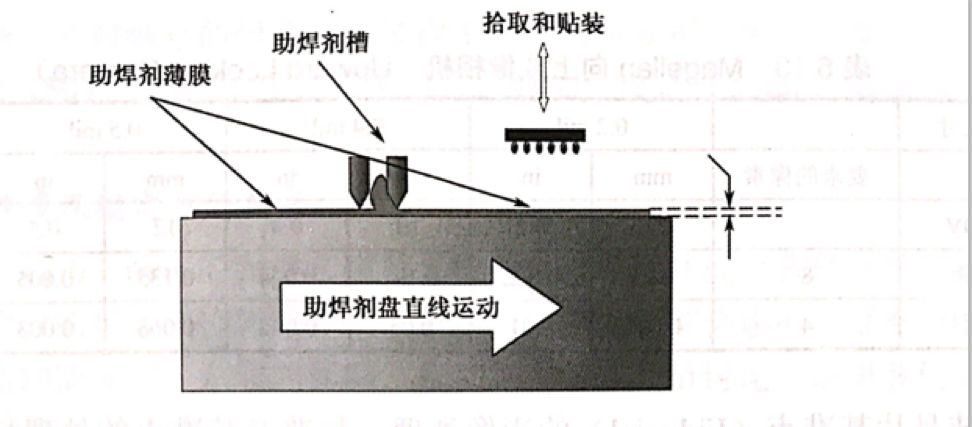
线性薄膜敷料器的优势:
线型驱动可确保薄膜厚度均匀及可重复性
快速转换的助焊剂盘及深度控制(无需调整)
最多可7轴一起进行群组浸蘸
典型的黏稠度10K至28.5K厘泊
可编程的回刮循环次数时间
可编程的浸蘸停留时间
可编程的维修监视器
快速释放治具、易于清洗
特大容量(能维持高达8小时的运作)
以贴装轴触控感应来确认浸蘸
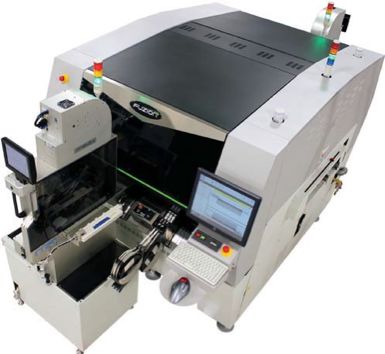
环球仪器的FuzionSC平台,是专门为应对先进封装组装而设计的,每台机器最多配备2个线性薄膜敷料器,能高速处理晶圆级CSP组装。
FuzionSC贴片机两大系列


下一篇:一文浅析单片机数码管中的上拉电阻

社群二维码

关注“华强商城“微信公众号
Copyright 2010-2023 hqbuy.com,Inc.All right reserved. 服务热线:400-830-6691 粤ICP备05106676号 经营许可证:粤B2-20210308